IBM и 3M создают "микропроцессорный клей" для создания слоеных чипов
На днях стало известно о том, что компании IBM и 3M ведут совместную разработку первого с воем роде клея, предназначенного для упаковки полупроводниковых схем в цельные блоки, своеобразные слоеные кремниевые башни. Целью сотрудничества двух компаний является создание нового класса материалов, способного сделать возможным производство коммерческих микропроцессоров, представляющих собой цельный блок и множества слоев, каждый из которых - отдельный чип. По предварительным данным IBM, число таких чипов-слоев может достигать сотни.
Практическая значимость подобной технологии очевидна: «слоеная» упаковка чипов позволит существенно увеличить уровни интеграции вычислительных узлов как для промышленных, так и для бытовых потребительских решений. Например, благодаря такой упаковке процессор можно поместить вместе с чипами памяти и сетевыми компонентами, в результате получится целый кремниевый модуль со скоростью до 1000 раз быстрее самых современных микропроцессоров. Сфера использования таких технологий – смартфоны, компьютеры, игровые консоли и многое другое.
Как говорят инженеры двух компаний, их исследования направлены на проектирование новой разновидности так называемых 3D-чипов, в которых на одной подложке из нескольких слоев располагаются множество процессоров. Исследователи отмечают, что существующие сегодня чипы, в том числе и содержащие в себе 3D-транзисторы, на самом деле являются 2D-чипами, так как по сути это плоские структуры.
Ученые намерены разработать такие материалы, которые будут способны упаковывать большие объемы вычислительных мощностей в новом ворм-факторе – кремниевом слоеном блоке. Бернард Мейерсон, вице-президент IBM Research, заявляет, что им удастся предложить новый класс полупроводников с высокими скоростями работы и низким потреблением энергии.
Практическая значимость подобной технологии очевидна: «слоеная» упаковка чипов позволит существенно увеличить уровни интеграции вычислительных узлов как для промышленных, так и для бытовых потребительских решений. Например, благодаря такой упаковке процессор можно поместить вместе с чипами памяти и сетевыми компонентами, в результате получится целый кремниевый модуль со скоростью до 1000 раз быстрее самых современных микропроцессоров. Сфера использования таких технологий – смартфоны, компьютеры, игровые консоли и многое другое.
Как говорят инженеры двух компаний, их исследования направлены на проектирование новой разновидности так называемых 3D-чипов, в которых на одной подложке из нескольких слоев располагаются множество процессоров. Исследователи отмечают, что существующие сегодня чипы, в том числе и содержащие в себе 3D-транзисторы, на самом деле являются 2D-чипами, так как по сути это плоские структуры.
Ученые намерены разработать такие материалы, которые будут способны упаковывать большие объемы вычислительных мощностей в новом ворм-факторе – кремниевом слоеном блоке. Бернард Мейерсон, вице-президент IBM Research, заявляет, что им удастся предложить новый класс полупроводников с высокими скоростями работы и низким потреблением энергии.
Похожее
Intel, IBM и Samsung вложат $4,4 млрд в разработку и производство чипов в США
Samsung приобрел разработчика чипов MRAM Grandis
Ученые создали образцы трехмерной цифровой памяти

Samsung переопределяет будущее флеш-памяти с новыми 3D V-NAND чипами
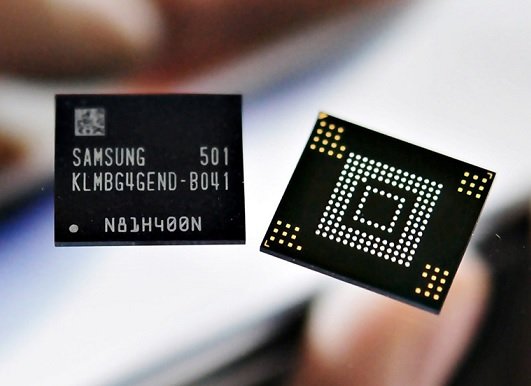
Samsung планирует сократить инвестиции в выпуск DRAM

Intel приступит к опытному выпуску 7-нм процессоров в 2017 году